

 |
 |
|
Разделы
Публикации
Популярные
Новые
|
Главная » Температурная зависимость смещения 1 2 3 4 ... 41 температурная зависимость смещения В 50-х годах развитие электроники/Столкнулось с такой проблемой, как надежность, обусловленной быстро возрастающими сложностью и размерами устройств и систем. Решение этой проблемы было найдено благодаря переходу к полупроводниковым компонентам. В результате введения кремниевой планарной технологии надежность дискретных активных компонентов повысилась в несколько десятков раз. К началу 60-х годов сложность ЭВМ и систем, применяемых в космических исследованиях, достигла такой степени, когда соединения между компонентами оказались менее надежными, чем сами компоненты. Кроме того, вследствие увеличения расходов на .разработку и производство большой номенклатуры дискретных комоонентов высокого качества цены на изделия чрезмерно возросли. Очевидно, что в подобных системах число межсоединений должно быть гораздо меньше, а их качество - значительно выше. Для уменьшения размеров и массы изделий необходимо на порядок увеличить плотность монтажа. Было также ясно, что метод инженерного мышления, ориентирующийся на отдельные компоненты, стал уже недостаточным, так как отмеченные выше требования можно удовлетворить только при использовании принципиально нового подхода. Осознание этого факта привело к широко распространенной ныне концепции интеграции. Ее главное достоинство заключается, в том, что создание групп соединенных между собой элементов схемы стало возможным в едином технологическом процессе. Интегральные схемы можно разделить на две основные группы: гибридные и полупроводниковые. При изготовлении гибридных ИС формирование пассивных элементов (резисторов, конденсаторов малой емкости, межсоединений) на .изолирующей подложке (стеклянной, керамической и т. п.) осуществляют методами шелкографии, катодного или вакуумного напыления, тогда как активные элементы и конденсаторы большой емкости изготавливают и монтируют отдельно. При создании полупроводниковых ИС все элементы (активные и пассивные) формируются в одном кристалле кремния. Полупроводниковые ИС более технологичны при массовом производстве, тогда как гибридные более пригодны для мелкосерийного производства схем специального назначения. Первое время казалось, что из-за чрезмерно больших допусков на параметры элементов и ограниченной номенклатуры выпускаемых функциональных узлов применение полупроводниковых ИС в аналоговой технике будет ограниченным. Однако со временем стало очевидным, что в результате некоторого усложнения технологии и лучшего использования таких методов, как формирование комплементарных транзисторов, сдвоенных пассивных эле- ментов и т. д., полупроводниковые структуры можно приспособить не только для гибридных, но и для схем, выполняемых на дис- кретных компонентах. С середины 60-х годов в технологии полупроводниковых структур наблюдался быстрый рост степени интеграции: от одиночных каскадов, например дифференциальных усилителей, к небольшим группам каскадов и далее к реализации многокаскадных аналоговых схем с заданными входными и выходными параметрами. Эти усовершенствованные схемы можно разделить на две категории: схемы общего назначения, способные работать в различных режимах и пригодные для построения более сложных систем, функциональные схемы, выполняющие функции системы или более' крупной подсистемы. Во втором случае разработчик ИС берет на себя довольно значительную часть функций разработчика систем. В настоящее время область применения, для которой разрабатываются функциональные схемы, ограничивается бытовой электроникой. В областях электросвязи, промышленной электроники, контрольно-измерительной техники и регулирования преобладают ИС общего назначения. Среди них большое практическое значение имеют два типа схем: операционные усилители и аналоговые перемножители. Первые используются как основные функциональные узлы в различных линейных и .нелинейных устройствах. Вторые предназначены в основном для нелинейных устройств. Хотя маловероятно, что они получат такое же широкое распространение, как операционные усилители, по своему значению они не уступают им. Ввиду сложности аналоговых интегральных схем предметное содержание данной книги ограничено упомянутыми выше двумя типами ИС. Они выбраны не только потому, что относятся к числу изделий, в наибольшей степени являющихся базовыми и используемых в самых разнообразных областях, но и потому, что оба типа ИС требуют от разработчика нового подхода, изложение которого является одной из главных целей настоящей книги. В гл. 2 и 3 кратко изложены основы технологии изготовления полупроводниковых ИС и анализа транзисторных схем, в гл. 4 дан обзор основных функциональных узлов на базе линейных ИС. Главы 5 и 8 содержат общее описание операционных усилителей и аналоговых перемножителей, а также подробное описание обширной группы серийно выпускаемых коммерческих моделей. Главы 6, 7 и 9 посвящены вопросам применения операционных усилителей и аналоговых перемножителей. При изложении материала учитывалось, что на смену мышлению в терминах каскадов пришло мышление в терминах узлов и блоков и что современные инженеры разрабатывают преимущественно более крупные функциональные узлы, а не привычные подсхемы. Автор надеется, что изложение нового подхода на достаточно большом числе разнообразных практических примеров даст прочную основу для успешного решения. ?адач по расчету и конструированию, не рассмотренных в данной книге. ТЕХНОЛОГИЯ ПОЛУПРОВОДНИКОВЫХ ИНТЕГРАЛЬНЫХ СХЕМ Технология .полулроводнишвыас ИС была разработана на осиове плаиар-но-эпитаксиалшой теянологаи ггранэиоторав. Этот MieTiOH важлючаепся в использовании трсцеосов ялаиарной даффуэии для фор^мирования диоирелных .транзисторов в эпитатсиальиом слое п-типа, выращеннам иа силыно легироваи-1!ой я+-1Подложке ,(рИ1С. 2Л). В результате сильного лепироваиия лодложка становится высокопроводящей, что, в свою оче-З/читглеп База SiO-. Р^ь, обусловливает малые объемные сопротив-\ \ / ления коллекторных областей. Зпигпаксиапьный п-споа п*- подпомка МоплЕнтор осуществляют через окна, полученные методом , фотолитографии в слое двуокиси кремния. На- Рис. 2.,1. Поперечиое сечение конец, пластину, содержащую ИС, разделяют пфемниевого планарно-эпитак- на отдельные кристаллы, которые герметизиру- сиалынош ггранаистора ют в корпуса. 2.1. Транзисторы типа п-р-п Изготовление мятегральных п-р-п чраизисторов во .многом сходно с кзро-товшвнйам диюкретных (ПраязисФоров. Освовиьге разлиния обусловлшы тем, что вместо (раэделекия 1на ютщельные приборы, транзистор)ьг -и (другие влемситы ИС остаются на общей подложке.. Слещрвателвно, сама структура должна обесие--чивать изоляцию различных элементов. Были раЗ|ра1бота.ньг методы иволяции^, из (которых метод изоляции посрндствош р-п лфёходюв оказался яа-иболее эко-ном^ичным 1И1 по-лучил самое широкое раогаросзранеиие. Он за1ключается в биру-женив коллвйтарных областей я-типа материалом р-типа и образава;вшийся; р-п переход в -процессе работы находится под напряжением обратного смещения. На лрактике inejpaoft операцией данного процесса Я1вляется выращивание эпитакоиашьвого слоя я-тепа яа подложке р-т1ипа. Коицеятрация, примеси, в слое .выбирается такой, чтобы иапряжения пробоя Коллектор-база находились-в пределах 40-=-ilOO В. -Следующая операция-соЗ|даяие изолирюеаяных ост-poBiKOB л-ггипа осуществляется диффузией примеси ib апитавдовальный слой шо-лиэующей матрицы р-типа (рис. 2-2). Внутри островков можно сформировать-п-р^я транзисторы шосрещством двух др-у.гах опера-ций даффузи (рис. 2.3). Типичный профиль легирования для -р-я транзисторов пок-аваи на piHC. 2.4, Концавтрация примеси .в эмиттерной обл-асти в несколько р-аз больше, чем в. коллекторной. В|сле)дстви1е этого яапря;жея1И€ лробоя эмиттернбаза. г-ораэдо меньше яапр'яжания щробоя жоллектюр-база. Типичные .пределы для EVсостав- . лякж 6-7 В. Если подложка находится шд иаибольшим отрицателъньш напряжением-(от источника питания ИС), то изолирующие переходы будут действовать- как -диюды IB режиме обратного смещения (рис. 2.6). Каж1дый островок будет-иволи|р.ован двумя последовательно (включенными, диодами. Токи утачкй этих диодов ирезвычайно малы и обыгано не ялияют на параметры элементов сформир-ованных в островках. Это страведливо ггажже в отношении сшрот|ИВ- 8 -1 лений 1Д1ИОД01В. Поокол-ьйу значание кййчдюш -ив них составляет около ilOO МОм, то .их вяяяеивм можно иренейречь .по сравнению с юопротивлеииями резисторов, иопольз]у,вм.ых ,в ИС, . . В .отличие от сопротивлевий и тю.К1ав утейки емкости ииощов оказывают значительное влияние иа Х1ар1а.кте|ри1ст1и в cxeiM, ib .частности на .ик работу в .области .высоких частот и скорость 1пере1ключе1ии1я. Эти m.koctik, существующие Змитглвр База /(оппентср SiOz изолирующая р-типа матрица Сстрпвок, л-типа Зпитапсиапьныи. спой п-типа 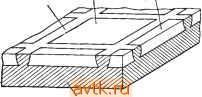 floffnowna р-глипа Ряс. 2.2. Островки л-тип-а р-ггипа IB П-одлоЖ'ке Змитглвр база Иоппектпр i Эпитансиальный п-споа p- лодттка Ваза  Эмиттер /(оппептор Рис. 2.3. И|нте1лральный транзистор с изолящвей о'братн'осмещен-ИЫ1М р-л переходам между .иоллактором и т'оиложкой, определяются су,м,М10Й 1пара.зиггных емкостей относительно дш и боковых стенюк островков. (П.ос.кольку .области коллектора и .подложки очень слабо легИрова.ны ,и межичу ними .имеетоя очень резкий переход, гго 1донные составляющие удельной вмиости дол'Ж1НЫ .быть малыми. Од-яаио площади донной части относительно .велики. Для .боковых составляющих Повдркность Область эмиттера п*-типа Эпитаксиапьный слой, п-гпипа Подпотт р-типа /(оицеитрицая прамеса, атом/см Лщепто т Ю 10 10Чо ю^ Донор  Зматтер Ширина базы Подлотпа I /<оппектор Расстояние от поВерхности.мкм \tz- - 1 Рис. 2.4. Типичный профиль ш.еги.ро1Баиия в п-р-п транаисторе справедливо обратное: удельные емкости достилают больших значений вследствие более сильного швгираван.ия боковых стенок, а пшощащи их ..меньше. В челом же значения допяьгх и боковых составляющих паразитных ем.костей имеют один .порядок. Их результирующее значение .м.ожно овиэвтъ путам уменьшения размеров проектируемых схем, котцрые ввиду этого- могут быть сформ.ированы в .меньших островках. Общая -емкость гкю.игектор-ятадложжа -загвисят от иапряжени.я обратиото смещения иа р-п переходах. Ее донные н -боковые составляющие обратно пропорциональны корню .кшаиратному и корню кубинеокому из обратного навря-жевия соответственно. .Различие объясняется тем, -что донные лереходы являются очеяь резкими, а бодавые - линейными.
А Подложка р-типа  Рис. 2.5. Модели островков, изолированных обратвосм.ещ№ньшя р-п переходами Рис. 2.6. Интегральный транзистор сО скрытым слоем iBcjietucTiBHe наличия изолирующего перехода интегральный транзистор, по-существу, Является иетырехслойной стргуктурой, ib которой области базы и-Коллекторй имеете с подложкой образуют дополнительный .даразиптный р-п-р' транзистор (см. ,jfHc. 2.4). Вы1би,рая соотношения .потенщиаиов, можно юбесле-ч-ить условия, шр-и которых паразитный ,т;ра.нзйстор будет всевда aauepTi, а его влияние -н€31на!чиаельн-о. .Большйнсттво рааличий между ивтегральньш м- дискретным транЗ'ИсторамЕ-можно объяония-ь следующими двумя фактарами': 1) поскольку коллектюрный-коитакт размещается яа верхней поверхности структуры, носители, -обуслов-ливающне кояле!кторны-й ток, долж1н-ы .проходить длинный iny№. Кроме того область .коллектора имеет высокое удельное .оопротнвлен'ие я малую площадь-поперечното сечения. iKa-к следствие, объбм;ное соп|рот.И|ВЛ€Н'ие коллбкггора и напряжение насыщения интегрального транзистора больше, а его частотная, характеристика х>уже, чем- у аналогичиого даоКретно1ло прибора; 2) емиостна капруэка колле1КТ10ра, обусловленяа'я иэолИ|рующим р-п переходом, яа1КЛадыва-ет дополнительные ограничения я.а частотную -характерийтику. 1Э,ффвкт1Ив.ным средством уменьшения объёмного совротивяевия коллектора-является ииффузи.я +-.слоя с малым удельным сопротивлением в подложку-р-типа (ДО начала эпитаксиальвого процесса. Шунгтру-я большое сопротивление коллекторной области, этот скрытый слой обеспечивает низкоомньгй путь к коллекторному кояггакту. Его .действие -примерно аналога-чво действию метал-л-взирюв-аявого н ж1него основания коллекторной области -(рис. 2.6). Работу иатешральиых п-р-п транзисторов в режиме малых оигааяов переменного тока можно описать, при- помощи эквивалентной схемы, предаггавлен-зюй на рис. i2.7, (которая оодержит ста1нда(р|тную -физическую гибридную П-об-ра-зную модель, а - также объемное сопротивление кол-лектора Гкк' и емкость, коллектор-подложка С . Так как эта емкость, обычно составлякяцая-, 1-3 пФ, Налагает существевные ограничения на применение транзистора в: iff Б fffS Б  Рис. 2.7. Физическая эк-. вИВалбытная схема ште-.оралыного транзистора сСлас*?? iBHicoiKBx частот, сопра-пнвлвние г^к' благодаря скрытому слою равиор-иестящка десяткам ом, слабо вшияет . а частотную характеристику и в да.н-иой эквмв'алеитнюй схеме его можно ие учцтываггь. Осноаное юграиичоние частотной характеристики интегралвного' уоилятель-ного .каскада обусловливается емкостью, б аза-коллектор Cg/ / , которую необходимо делать как можно меньше. Поскольк1у С и объемное сопротивле- и,е 1бавы сб з-а^висдт от даонцентрэдии .цримеси в 01б1л.а1сти базы, принято вы- б'ирать концвнглрацию та1кой, гатобы nipoHaBemejfflie r,C,r было оптималь-jibj.vt. В мпогакаокадных усилителях внутреннее сопротивление источ1 вка сигнала обычно .значительно лр€.вышает rflg/. Это поз.вотяет !устана1вливаггь ужа-заиную выше 1нонцентрацию такой, чтобы eiMiKocTb С была мивимальвой, aeoMiOTpH .на гу!велвчвн.йе сопротивления г^,. Область эм:вттвра формируют в слоях с малым уде'льны.м сопротивлением. Вследствие этого объемное сопротивлевве эм1И1ТФе.ра и .пробивное яа1П|р.яженИе эмиттер-база оказываются малыми - обычно 2-3 Ом и 6-7 В юоответсг- веяно. Типоичмые значения пара.мет.ров .интегральных п-р-п гранзисторов сведены S табл. 2.1. Таблица 2.1 Параметры интегральных п-р-п транзисторов
Во входных каска1дах некоторых типов ИС используются транзисторы с *очень .большим коэффициентом усиления. При фор(М|Ираван:ии та.ких траязисто-ров глубокая эмиттерная диффузия в .область базы проводится до тех .пор, П'Ока амиггтер не окажется иа очень малом раостоя.ни-и .от коллектора. По-скошьку пр.и этом .не только (увеличивается коэффициент .усиления .по току, ню и (уменьшается .напряжение .пробоя, для обеспечения напряжения коллектор-база .близким 1к нулю неза1В.вси.м-о от -уцравляюшего напряжения на базе применяют (Метод плавающе(го( потенциала или некоторые друГНе методы. 2.2. Резисторы Интепралвные резисторы-можнО'выполнять одновременно с актив.ными эле-iMeHTaMiB. Один из 1в.оэможных методов заключается в использованви базовой лиффуэни для формирования резисторов в эпитаксиальных островках Путина (рис. 2.8). Одна.ко войства Tsmsx резисторов предопределяются процессом, о.риентИроваииым яа и-згогговлешие т|равз(И1стор©1В. Получаемые значения сопротивления слоя .находятся в пределах 100-200 Ом/кваьщрат, что позволяет реализовать значения сопротивлений в диапазоне от 20 Ом до 50 кОм. При определенном удельном сопротивлении слоя получаемое енаненяе сопротивления зависи(Г от ширины и длины диффузионной области резистора. Поскольку, ее ширина огр.аяя.ч€на конечной разрешающей способностью фотолитографии, для получения (больших сопротивлений Т1ребуются относительно длинные диффузионные полоски. Для соз1да1НИя межсоединений необходимы площадки выводных контактов .надлежащих раЗ|Меров, что также оказывает небольшое влияние на значение соиротивления. Ж В J) SiOz Зпитаксиапьный п-спои К
RRs (Ча) * И5=то...гооофВадрат РЯс. 2.8. Резистор, сформир'Ован-яый на этапе базовой диффузии Рис. 2.9. Резистор, сформирован-Hbrii на этапе эмиттерной диффу-еии  Для получения малых значений сопрогимения используется эмиттерная-диффузия (рис. 2.9). Типичные значения сопр.отивлеяня слоя сишьно легированной эмигттерной области лежат в пределах 2-3 Ом/ивадрагг. Для резисторов, сформированных (методом диффузии, всегда характерна некоторая температурная зависимость номинала, степень (которой определяется конщентрацней примеси. Например, температурный . коэффициент резистора с сооротивлениам слоря 150 Ом/кваират, выполненного на этапе (базовой диффузии, достигает 0,05-0,2%/° С, а резистора с сопротивлением слоя 2,5 Ом/наад-рат, полученного иа этапе^ эмиттерной диффузии, всего 0,01%/° С. В рез(Истора-х, сформированных на этапе , базовой диффузии изоляция от подлож1к1и обеспечивается 1вм1костями двух р-п переходов. Эта паразитная нагрузка (резистора завиоат от местоположения вьпводного (контакта к неолирую-щсй области. Если такой контакт (Z) на рис. 2.8) расположен на конце диффузионной полоски с более положительным потенциалом, то одна из емкостей перехода будеж включена параллельно резистору, а другая-между подложкой и концом диффузионной полоски, как показано на рис. 2.1i0a. Такая кон- Л R В D Оп 1 fi R В П UJj R В о-1 I-о р-о Рис. 2.10. Модели резистора, сформированного' на этапе базовой диффузии фигурация используется для изготовления делителей напряжения с частотной-компенсацией. В линейных интелральных схе.мях область /г-типа обычно находится под нанбошьшам (положительным на.П|ряжением от источника пнтаниа-(рис- 2.106). В та1мих случаях переход резистор-коллектор действует как' емкостная нагрузка, распределеиная (по всей (длине диффузиоявой (полоски^, и его можно представить так, как показано а рис. 2.10в. Для резисторов с тйпич-ными\н^а|чення,м1и. сопротивления слоя и типмчион шириной полоски у.к.аеалиая 1вьгше иагрузка лежит а пределах 0,1-0,-5 пФ/дOLM. Ее значение пропорцио-иаяьио илощади поверхности нли квадрату ширины полооюи при постояншом с,&прот1ИвЛ(ен.и1н слоя. С учетом последнего .обстоятельства и С целью эковом.ич-.ко-го И1спо:яьзов.антя площади полупроводниковой иласданки ш-ирвиа резистцр-иых полосе делается как иожно меньше. Однако при этом следует принимать во в.ни1М.а1НИй коиечиую разрешающую опос0бность фотошитолрафии и допустимый раз|0рос\1сопротив1Л©ния резисторов ютвосительно номинала. оняые резисторы яе только Ч|увс.тшитель1нъ1 к изменению температуры, но танже имеют чрезмерио большой пронаводств^енный допуск на аб-солклтнью anateHHiH сопрютивлений - обычно 20% при (ширине полоски в несколько м)Шфои. Гк)эт1аМу для 10(преяел€нил характеристик схемы предпочтительнее применять отно(ше(Н я сопротившений резисторов, (которые можно вы-дерЖИвать с (точ-ростью 0,5-2%. Значения сопротивления слоя ,10-ЮО (кОм/нвадрат можно реализовать по-срейством проведения диффуаим чслои (в полосну р-типа до тех пор, иака тслщина последней не станет соизмеримой с ,толЩИнюй обедиенной области у р-п перехода (рис. 2.(11). Такую опвра(цию можно -осуществить ояновременнр Ж Р.ИС. 2.11. Пй1нч-1резистор с эмяттерной диффуэией при ооада.нии активных элементов. Однагко это со-прот1И1влеви€ .будет зашсегъ от натряжения между э(пита1ксиальным слоем т? полоской, а также (От тока, (протекающего через резистор. Ввиду указанных зависимостей, из которых первая обусловлена уменышеннон толщи'ной, а вторая-падением напряжения на полоаке (при протекании по ней тока, та.к называемые оинн-резисторы испюльзуются дов'олъно редко, только в tei случаях, когда (нео|бх;оД1има (К'ОМ(пенсащия проивводстввннопо ра-зброса И температурной зав.исимо|сти параметров транзисторов, сформированных одно(В!ременио с пас-CHBflbiMiB элв.\1е1н:таМИ. Мхшто показать, что они хорошо подходят для решения .пюшедней задач(и, таж как их размеры и 1сте(пень легирования такие же, как у базовых областей. 1В некоторых случаях выгоднее создавать полоски в эиитаксиалъной коЛ-о'вкторно'й области с большим удельным сопротивлением. Ч|увстви.тельностъ таких резистароЕ ik жменениям температуры примерно такая ж'с, (как и у пин'ч-peaHicTopoiB, однако их оо(11роти(ВЛение не .зав(и1сит (от напряжения. В основяова они (прим-еняются для температурной К01м(пенса1ции других .элементов. 1Цр.и .из1потовлвнии аы1оо(коомн'Ых (прецизионных резисторов можно сочетать иолу(п-р1авод(нмковую ггехнолюгИю с тоикопленояной. .В этом случае осаждение пассивных элеме'Нтов осуществл'яется непосредственно на окясный слой кристалла, .иоклЮ|чая (диффузию. Тиспичные значения согар(отивлени1я, .температурного коэффициента и пр(аиз1водственного допуска таких тонкюшленочиых резисторов составляют соответственно: 20 ikOm-1 .МОм, О-0,2%/°С 1И (менее 1%. 2.3. Конденсаторы простейший способ ф|0)рм1Ирова и.я е1М1И0стных эле(М'е(н.Т01в - это создание F-n перахощов методом диффузии о'диоврбменно с транзисторами и .пoд^Jepжaт иие их при работе в реж.име обратного омещеаия. К (сожалению, .конденсатор такого Т1ииа- В(меет серьезные .недостатки, а именно: емйооть зависит от напря- жения и (возяикающие чрезмерные потери обусломены- юбъемным оопротив-лб вм элеаотродов; / Для коллвкпор'Вочбааавого варианта, структура- и эмвивалентная схема wOiToporo покаваны на рис. 2Л2 и 2.13, удеявна.я емкость относительно мала, обычно 150 иФ/мм шри coBipaTHOM смещении -5 В, а нашряжени-е тробоя велико, примерно- такое же, как у сфорМ1ирова1Нных однавременио с ним транзисторов. Чрезмерно большое шсле1Д01вательное сопротивление к^лшекториой обла!сти iRs, выполненной в выюокою-мном апитаксиальвом слое, можно- уменьшить п'Оорещством оозщания скрътого слоя (ом. § 2.1). .Бсл.в ни/однв вывод конденсатора не заз€1мле!Н, то необхрощимо -учитывать нараэитную/емкость кол-лекторнподло-жка, которая может иметь ананения такого же 1П|(!радка, что -ч емкость -перехода.  -Рис. 12.12. -.К'оллактортаочбазовый ва-Р-иаит емкостного элемента иа р-п \ переходе Ряс. 2;13. Эквивалентная схема интегрального ков-денсатора На р'ИС. 2.14 локазан базово-эмлттерный вариант конденсатора на р-п переходе, емкость которого обычно составляет ilOOO вФ/мм при напряжении обратного смещения -2 В, а напряжение пробоя меньше, чем - для предыдущего варианта конденсатора. Эпитаксиальный слой п-типа может быть вы- /! В  Рис. 2.14. Эмиттерио-базовый вариант интегрального конденсатора веден ил,и яс выведен на поверхность. iB первом случае епо необ-Х10(димо поддерживать под наибольшим положительным напряжением. Во втором случае нежелательная емкость относительно подложи будет несколько меньше, но плавающая база паравишного транзистора может вызвать нарушение нормальной работы при более высоких напряжениях. Гораздо лучших параметров можно достичь при иснользовании структуры, показанной на рж. 2.15; в ней диэлектриком между эмиттерной -даффузя-он-ной областью с малым удельным сопротивлением и осажденным слоем металла 1служит слой окиои кремния, выращенный на кристалле, или нитрида кремния (Si3N4). У конденсатора этого типа емкость я напряжение пробоя  Рис. 2.15. Конденсатор со структурой (мегалл-рокисел-полупроводник ,во веяики: обычно 500 пФ/мм и 40 В при малых потерях. Напряжение Чробоя зависит от ТО.5ЩЯ1НЫ диэлвктр.И1ка, жюитроль которой требует дополнительной техиологичеакон операции. Изоляцию от подложки можно обеспечит , путем подагаи па электрод пол'улроводникового слоя положительно-по напряяЦния. Если это папряжение достаточно велико, то нежелательная ем1К0Сть ои1(0сительн10 подложки (будет мала. Следует заметить, что емтость слабо зависит от яарря!жеиия вследствие влияиия О'бедненН'О-перехода днэлвктрИ1К-полуП|ровоИ'НИ1К, що Пока напряжение, при-енсатору, не слишком велико, эта зависимость будет цракти- таких элема го слоя ложемное к чЛви неэам' 2.4. Транзисторы типа р-п-р Требования, жоторым должны удовлетворять современные интегральные схемы, не позволяют пренебрегать и р-п-р траиз'Исторами. Из многочисленных методов aKOHOMHiHecKH оправданными оказались те, в осн'ове которых лежат та1кие же технолйгаческие операции, что и при изготовлении п-р-п транзисторов. \ Стр1у.ктур!у (р'ис. 2.II6), в (Которой транзист0(рный эффект проявляется в го; ризонгальНОМ наеравлении, можно получить, (используя базовую диффузию п-р-п Tpa(Hi3incmoipo(B 1.П|ля формирО'ванвя эмиттера р-т.ипа (и кольцевог.о коллектора р-типа в эпитаисиаль'ном п-1слое. Потенциал ам1иттера О'бычио более положителен по отно.шенИЮ к потенциалу базы, поэтому подложка действует как - вторичный колле.ктор и поглош.ает неиотцрую часть горизонтального эмит-TCipnoro тока, (вследствие чего коэффициент усиления прямого тока аь (при вклюлевви с абпш бавой) бу)дет отнооительно малым (здесь индекс L означает гориз|онтальну(ю структуру). Значение коэффициента аь зависит в ос-вовном от отношения длин (путей токов эмиттер-Коллвктор и эмиттер-подложка И Л40жет быть увеличено при помощи соящаивя очрытого п+-слоя, который уменьшИТ долю эмнттерного тока, текущего в направлении подло'жки. КоппЕшор\ Коллемтор Рис 2Л6. Горизонтальный р-п-р 1 \ , оаза 51.D2 тр-анзистор fif п  Рис. 1X1. Вертикальный транзистор Эмиттер Ваза iq т р-ноппектор Коэффициент Pi - отношение тока Колле(кТ0ра к току базы - зависит от реиом'бинации, -а не от ai,. Так, .указанный коэффициент -может быть велик< даже если at 1мал. Однако допустимый раабр'ОС pa0Mie(p(QB ма&кн Обыч-но sa-трудняет эффективный контроль значительно больших -коэффициентов усиления ПО току. Э-т-у трудность мож(но (Преодолеть, используя (внутреннюю обратную связь, которая реа1лнзуется путем разделелия коллектюр'ной (области на Два неоди а(ков'Ых ,по раамерам сепмента и ооединеняя меньшего та них с базой. Можно показать, что единственным .фактором, .который (влияет на реауль-тир-ующий (Коэффициент (усиления по ток]у, .я.вляется Отношение .площадей (поверхностей указа.нных сеаментюв {С'М. § 4.3). - - 1 2 3 4 ... 41 |
|||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
© 2004-2025 AVTK.RU. Поддержка сайта: +7 495 7950139 в тональном режиме 271761
Копирование материалов разрешено при условии активной ссылки. |